LGA vs BGA: คู่มือวิศวกรรมสําหรับการเลือกแพ็คเกจชิป
บรรจุภัณฑ์ชิปมีบทบาทสําคัญในประสิทธิภาพทางไฟฟ้า การจัดการความร้อน ความน่าเชื่อถือทางกล และความสามารถในการซ่อมบํารุงผลิตภัณฑ์ ในบรรดาแพ็คเกจเซมิคอนดักเตอร์สมัยใหม่ Land Grid Array (LGA) และ Ball Grid Array (BGA) เป็นเทคโนโลยีที่โดดเด่นสองอย่างที่ใช้ใน CPU, ระบบฝังตัว, อุปกรณ์อิเล็กทรอนิกส์เคลื่อนที่ และโมดูลยานยนต์
บทความนี้อธิบาย โครงสร้างทางวิศวกรรม กระบวนการประกอบ ลักษณะทางไฟฟ้า ข้อควรพิจารณาด้านความน่าเชื่อถือ และการใช้งานในโลกแห่งความเป็นจริง ของแพ็คเกจ LGA และ BGA นอกจากนี้ยังให้คําแนะนําเชิงปฏิบัติสําหรับนักออกแบบฮาร์ดแวร์เกี่ยวกับวิธีการเลือกแพ็คเกจที่เหมาะสมตาม ความสมบูรณ์ของสัญญาณ ประสิทธิภาพการระบายความร้อน ข้อจํากัดทางกล และการบํารุงรักษา
สารบัญ
- 1. ความรู้เบื้องต้นเกี่ยวกับบรรจุภัณฑ์ IC สมัยใหม่
- 2. อาร์เรย์กริดที่ดิน (LGA)
- 3. บอลกริดอาร์เรย์ (BGA)
- [4. ความแตกต่างของโครงสร้างและทางไฟฟ้าระหว่าง LGA และ BGA] (# 4 ความแตกต่างของโครงสร้างและไฟฟ้าระหว่าง LGA และ BGA)
- [5. ความน่าเชื่อถือทางกลและพฤติกรรมทางความร้อน] (#5-ความน่าเชื่อถือทางกลและพฤติกรรมความร้อน)
- [6. วิธีการประกอบ การบัดกรี และการตรวจสอบ] (# 6-วิธีการประกอบบัดกรีและการตรวจสอบ)
- 7. สถานการณ์การใช้งานทั่วไป
- [8. ความสูงของแพ็คเกจและการรวมระบบ] (# 8-ความสูงของแพ็คเกจและการรวมระบบ)
- 9. แนวทางทางวิศวกรรมสําหรับการเลือก LGA หรือ BGA
- 10. คําถามที่พบบ่อย
- 11. สรุป
1. ความรู้เบื้องต้นเกี่ยวกับบรรจุภัณฑ์ IC ที่ทันสมัย
บรรจุภัณฑ์วงจรรวมมี ฟังก์ชันทางวิศวกรรมที่จําเป็นสามประการ:
- การเชื่อมต่อโครงข่ายไฟฟ้า ระหว่างซิลิกอนดายและ PCB
- การป้องกันทางกล ของแม่พิมพ์เซมิคอนดักเตอร์
- เส้นทางความร้อน สําหรับการกระจายความร้อน
เมื่อวงจรรวมมีความซับซ้อนเพิ่มขึ้นแพ็คเกจตะกั่วแบบดั้งเดิมเช่น QFP จึงต้องดิ้นรนเพื่อรองรับ จํานวนพินสูงสัญญาณความเร็วสูงและเลย์เอาต์ที่กะทัดรัด ที่จําเป็นสําหรับอุปกรณ์อิเล็กทรอนิกส์สมัยใหม่
เพื่อจัดการกับข้อจํากัดเหล่านี้ เทคโนโลยี แพ็คเกจอาร์เรย์พื้นที่ เช่น LGA และ BGA จะกระจายการเชื่อมต่อไปทั่วด้านล่างทั้งหมดของชิป ซึ่งเพิ่มความหนาแน่นของการเชื่อมต่ออย่างมีนัยสําคัญและปรับปรุงประสิทธิภาพทางไฟฟ้า
2. อาร์เรย์กริดที่ดิน (LGA)
2.1 การออกแบบโครงสร้าง LGA
แพ็คเกจ Land Grid Array (LGA) ใช้ แผ่นนําไฟฟ้าแบบแบน (ที่ดิน) จัดเรียงเป็นกริดที่ด้านล่างของพื้นผิวบรรจุภัณฑ์ แผ่นอิเล็กโทรดเหล่านี้เชื่อมต่อกับ:
- หมุดซ็อกเก็ตแบบสปริงโหลด หรือ
- ข้อต่อบัดกรีโดยตรง กับแผ่น PCB
ในระบบเดสก์ท็อปและเซิร์ฟเวอร์ พินจะอยู่ในซ็อกเก็ตแทนที่จะอยู่บนโปรเซสเซอร์ ซึ่งช่วยลดความเสี่ยงที่จะทําให้ CPU ราคาแพงเสียหายระหว่างการจัดการ
รูปแบบที่ใช้กันอย่างแพร่หลายคือ Flip-Chip LGA (FCLGA) ในสถาปัตยกรรมนี้:
- แม่พิมพ์ซิลิกอนพลิกคว่ํา
- การกระแทกของไมโครบัดกรีเชื่อมต่อแม่พิมพ์กับพื้นผิวบรรจุภัณฑ์
- ความร้อนกระจายผ่านด้านหลังของแม่พิมพ์ได้อย่างมีประสิทธิภาพมากขึ้น
การกําหนดค่านี้ช่วยลด ความเหนี่ยวนําของการเชื่อมต่อระหว่างกันและความยาวเส้นทางสัญญาณ ซึ่งช่วยปรับปรุงประสิทธิภาพความเร็วสูง
องค์ประกอบโครงสร้างที่สําคัญ
- พื้นผิวบรรจุภัณฑ์อินทรีย์
- ชั้นการกระจายทองแดง
- ที่ดินสัมผัสชุบนิกเกิล-ทอง
- ตัวกระจายความร้อนในตัว (IHS) ที่เป็นอุปกรณ์เสริม
2.2 ลักษณะทางไฟฟ้าและความร้อน
แพ็คเกจ LGA มีข้อดีทางไฟฟ้าหลายประการ:
หน้าสัมผัสความเหนี่ยวนําต่ํา
เส้นทางสัญญาณที่สั้นลงช่วยลดการเหนี่ยวนําของปรสิต ซึ่งเป็นประโยชน์สําหรับอินเทอร์เฟซความถี่สูง เช่น PCIe และบัสหน่วยความจํา
ความสามารถในปัจจุบันสูง
แผ่นสัมผัสขนาดใหญ่ช่วยให้เครือข่ายการจ่ายไฟ (PDN) ดีขึ้นทําให้ซีพียูสมัยใหม่สามารถดึงกระแสไฟชั่วคราวได้มากกว่า 200 A
ประสิทธิภาพการระบายความร้อน
ความร้อนจะถูกถ่ายเทโดยตรงจากตัวกระจายความร้อน→→ฮีทซิงค์ ให้ความสามารถในการระบายความร้อนที่ดีเยี่ยมในระบบเซิร์ฟเวอร์
3. บอลกริดอาร์เรย์ (BGA)
3.1 การออกแบบโครงสร้าง BGA
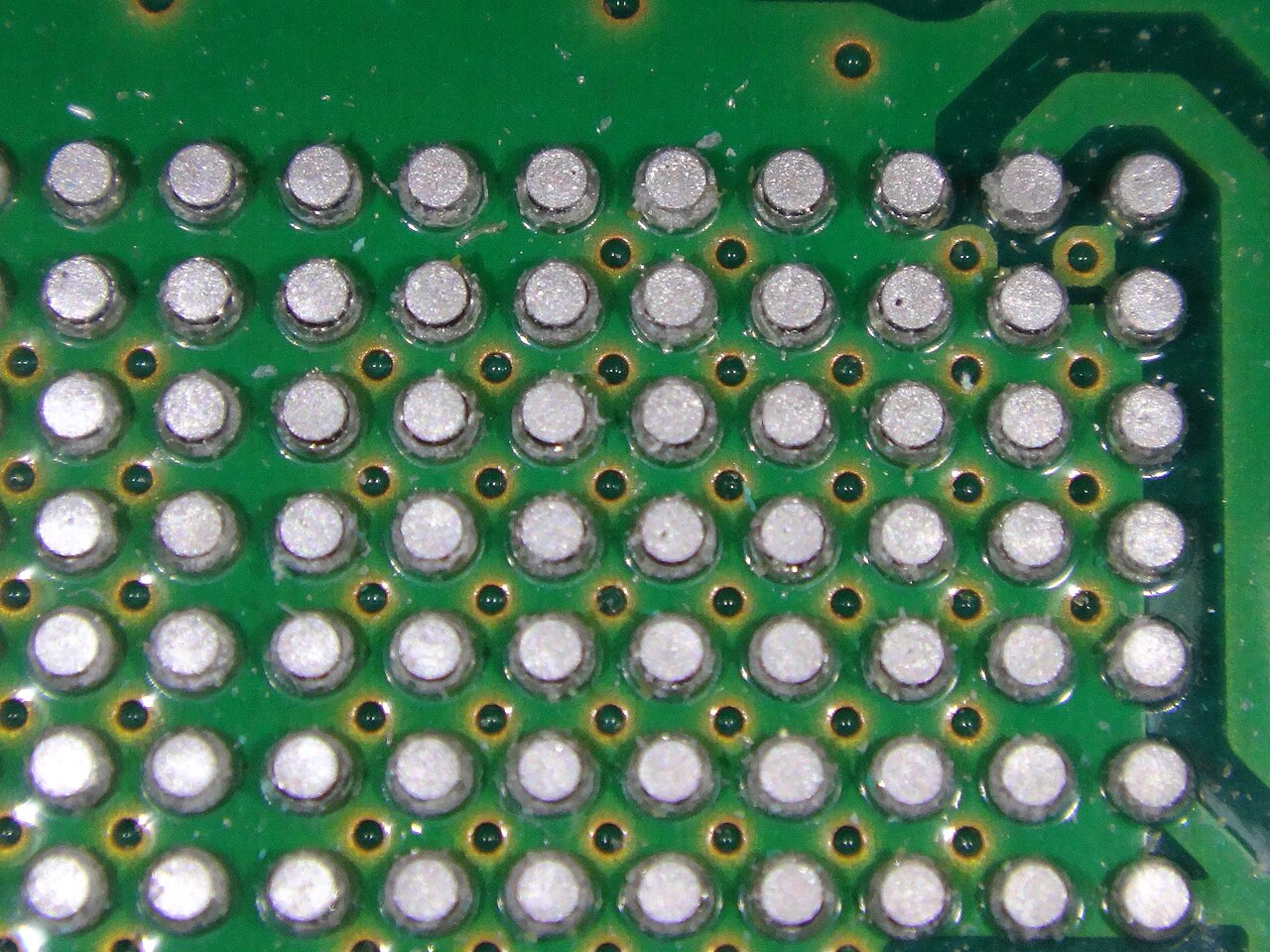
แพ็คเกจ Ball Grid Array (BGA) ใช้ อาร์เรย์ของลูกบัดกรี ที่ด้านล่างของอุปกรณ์เป็นการเชื่อมต่อทางไฟฟ้า
ระหว่างการผลิต:
- วางประสานถูกนําไปใช้กับแผ่น PCB
- วางอุปกรณ์ BGA โดยใช้อุปกรณ์หยิบและวาง
- บอร์ดผ่าน เตาอบรีโฟลว์
- ลูกบัดกรีละลายและสร้างข้อต่อถาวร
เนื่องจากการเชื่อมต่ออยู่ใต้แพ็คเกจ BGA จึงรองรับ **ความหนาแน่นของ I/O ที่สูงกว่าแพ็คเกจที่มีสารตะกั่วมาก
โครงสร้างแพ็คเกจภายใน
เลเยอร์ BGA ทั่วไป ได้แก่ :
- แม่พิมพ์ซิลิกอน
- สายพันธะหรือการกระแทกของชิปพลิก
- พื้นผิวลามิเนตอินทรีย์
- หน้ากากประสาน
- อาร์เรย์บอลบัดกรี
3.2 ลักษณะทางไฟฟ้าและความร้อน
BGA มีข้อดีด้านประสิทธิภาพหลายประการ:
ความหนาแน่นของการเชื่อมต่อสูง
การเชื่อมต่อ I/O หลายพันรายการสามารถรวมเข้ากับขนาดกะทัดรัดได้
ความสมบูรณ์ของสัญญาณที่ยอดเยี่ยม
การเชื่อมต่อระหว่างกันในแนวตั้งที่สั้นลงช่วยลดความไม่ต่อเนื่องของอิมพีแดนซ์และการรบกวนทางแม่เหล็กไฟฟ้า
ปรับปรุงการนําความร้อน
ความร้อนสามารถกระจายผ่านทั้งด้านบนของแพ็คเกจและอาร์เรย์ลูกบัดกรีเข้าไปใน PCB
คุณสมบัติเหล่านี้ทําให้ BGA เหมาะสําหรับ โปรเซสเซอร์มือถือ, GPU และหน่วยความจําความเร็วสูง
4. ความแตกต่างของโครงสร้างและทางไฟฟ้าระหว่าง LGA และ BGA
| ลักษณะเฉพาะ | แอลจีเอ | บีจีเอ |
|---|---|---|
| ประเภทการติดต่อ | แผ่นแบน | ลูกบัดกรี |
| วิธีการแนบ | ซ็อกเก็ตหรือบัดกรี | การบัดกรีแบบรีโฟลว์ |
| ความสามารถในการเปลี่ยน | เปลี่ยนได้เมื่อเสียบปลั๊ก | ถาวร |
| ความหนาแน่นของสัญญาณ | จุดสูง | สูงมาก |
| ความยากในการซ่อมแซม | ปานกลาง | จุดสูง |
| การตรวจสอบ | ภาพ + เอ็กซ์เรย์ | ส่วนใหญ่เป็นการเอ็กซเรย์ |
ความแตกต่างพื้นฐานคือ LGA แยกหน้าสัมผัสทางไฟฟ้าออกจากข้อต่อบัดกรี ในขณะที่ BGA รวมเข้ากับโครงสร้างลูกบัดกรีเดียว
5. ความน่าเชื่อถือทางกลและพฤติกรรมทางความร้อน
.jpg)
ความน่าเชื่อถือทางกลขึ้นอยู่กับ การหมุนเวียนความร้อนและความเค้นเชิงกล
ข้อควรพิจารณาเกี่ยวกับความน่าเชื่อถือของ BGA
ข้อต่อบัดกรี BGA สัมผัสกับ การขยายตัวทางความร้อนไม่ตรงกัน ระหว่าง:
- ซิลิคอนดาย
- พื้นผิวแพคเกจ
- วัสดุ PCB
รอบอุณหภูมิซ้ําๆ อาจทําให้เกิด การแตกร้าวของบัดกรี
เพื่อบรรเทาปัญหานี้ นักออกแบบมักใช้:
- วัสดุอุดด้านล่าง
- ลามิเนต PCB Tg สูง
- องค์ประกอบโลหะผสมบัดกรีที่ปรับให้เหมาะสม
ข้อควรพิจารณาเกี่ยวกับความน่าเชื่อถือของ LGA
ซ็อกเก็ต LGA หลีกเลี่ยงความล้าของการบัดกรีเนื่องจากการเชื่อมต่อเป็น กลไกมากกว่าโลหะวิทยา อย่างไรก็ตาม พวกเขาแนะนําความเสี่ยงอื่น ๆ :
- หมุดซ็อกเก็ตงอ
- ความแปรผันของความต้านทานการสัมผัส
- ลดความน่าเชื่อถือในสภาพแวดล้อมที่มีการสั่นสะเทือนสูง
ดังนั้นโดยทั่วไปแล้วซ็อกเก็ต LGA จะใช้ใน สภาพแวดล้อมที่มีการควบคุม เช่น เซิร์ฟเวอร์และเดสก์ท็อป
6. วิธีการประกอบ การบัดกรี และการตรวจสอบ

กระบวนการผลิตแตกต่างกันอย่างมากระหว่างสองแพ็คเกจ
แอลจีเอแอสเซมบลี
มีสองแนวทาง:
ซ็อกเก็ต LGA
- ใส่ CPU ลงในซ็อกเก็ต
- แผ่นโหลดยึดแรงดันสัมผัส
- อนุญาตให้เปลี่ยนฟิลด์
LGA บัดกรีโดยตรง
- วางประสานกับแผ่น PCB
- แพ็คเกจรีโฟลว์บัดกรีคล้ายกับ QFN
การประกอบ BGA
แพ็คเกจ BGA ต้องการกระบวนการ SMT ที่แม่นยํา:
- การพิมพ์ลายฉลุ
- การจัดตําแหน่งแบบหยิบและวาง
- การจัดทําโปรไฟล์อุณหภูมิแบบรีโฟลว์
การตรวจสอบโดยทั่วไปเกี่ยวข้องกับ:
- การตรวจสอบด้วยแสงอัตโนมัติ (AOI)
- การตรวจเอ็กซเรย์
เนื่องจากข้อต่อบัดกรีซ่อนอยู่ใต้บรรจุภัณฑ์
7. สถานการณ์การใช้งานทั่วไป
แอปพลิเคชั่น LGA
- โปรเซสเซอร์เดสก์ท็อป
- ซีพียูเซิร์ฟเวอร์องค์กร
- เวิร์กสเตชันระดับไฮเอนด์
- อุปกรณ์เครือข่าย
ระบบเหล่านี้ได้รับประโยชน์จาก ความสามารถในการซ่อมบํารุงและความสามารถในการอัปเกรด
แอปพลิเคชั่น BGA
- สมาร์ทโฟน
- แท็บเล็ต
- จีพียู
- DRAM และหน่วยความจําแฟลช
- ECU ยานยนต์
- โมดูลการประมวลผลแบบฝังตัว
ระบบเหล่านี้ให้ความสําคัญกับ การออกแบบที่กะทัดรัดและการผสานรวมสูง
8. ความสูงของแพ็คเกจและการรวมระบบ
| หมวดหมู่ | แอลจีเอ | บีจีเอ |
|---|---|---|
| ความสูงของส่วนประกอบ | ปานกลาง | ต่ํา |
| ซ็อกเก็ต | กระแทกเพิ่ม 3–6 มม. | ไม่มี |
| ความหนาแน่นของ PCB | ปานกลาง | จุดสูง |
| โปรไฟล์อุปกรณ์ | สูงกว่า | กะทัดรัดมาก |
สําหรับ อุปกรณ์บางเฉียบ BGA มักจะเป็นตัวเลือกเดียวที่ใช้งานได้จริง
9. แนวทางวิศวกรรมสําหรับการเลือก LGA หรือ BGA
นักออกแบบฮาร์ดแวร์มักจะประเมินปัจจัยสี่ประการ:
1. ความสามารถในการซ่อมบํารุง
หากโปรเซสเซอร์ต้อง เปลี่ยนหรืออัพเกรดได้ ให้เลือก LGA
2. พื้นที่คณะกรรมการ
สําหรับ เค้าโครง PCB ขนาดกะทัดรัด BGA ให้ความหนาแน่น I/O ที่เหนือกว่า
3. การจัดการความร้อน
โปรเซสเซอร์กําลังสูงมักใช้ LGA กับตัวกระจายความร้อนขนาดใหญ่
4. ความซับซ้อนในการผลิต
BGA ต้องการ ความสามารถในการควบคุมและตรวจสอบกระบวนการ SMT ขั้นสูง
10. คําถามที่พบบ่อย
เหตุใดแล็ปท็อปจึงมักใช้โปรเซสเซอร์ BGA
แล็ปท็อปให้ความสําคัญกับ ฟอร์มแฟคเตอร์ที่บางและเค้าโครง PCB ขนาดกะทัดรัด ซึ่งแพ็คเกจ BGA เปิดใช้งานโดยการกําจัดซ็อกเก็ต
ชิป BGA ไม่สามารถเปลี่ยนได้หรือไม่?
ไม่ สามารถเปลี่ยนได้โดยใช้ สถานีทํางานซ้ํา BGA แต่กระบวนการนี้ต้องใช้อุปกรณ์เฉพาะทางและช่างเทคนิคที่มีทักษะ
เหตุใดซีพียูเดสก์ท็อปจึงยังคงใช้ LGA
ระบบเดสก์ท็อปให้ความสําคัญกับ ความสามารถในการอัปเกรดและความสามารถในการซ่อมบํารุง ทําให้ผู้ใช้สามารถเปลี่ยนโปรเซสเซอร์ได้โดยไม่ต้องบัดกรี
แพ็คเกจใดให้ความสมบูรณ์ของสัญญาณที่ดีกว่า
ทั้งสองสามารถทํางานได้ดี อย่างไรก็ตาม BGA มักจะให้เส้นทางสัญญาณที่สั้นกว่า ซึ่งเป็นข้อได้เปรียบสําหรับอินเทอร์เฟซความเร็วสูงมาก
11. สรุป
LGA และ BGA เป็นตัวแทนของกลยุทธ์บรรจุภัณฑ์ที่ครบถ้วนแต่แตกต่างกันโดยพื้นฐาน
- LGA ให้ความสําคัญกับ ความสามารถในการซ่อมบํารุง การจ่ายพลังงาน และการระบายความร้อนประสิทธิภาพสูง
- BGA มุ่งเน้นไปที่ การย่อขนาด ความหนาแน่นของการรวม และประสิทธิภาพการผลิต
การทําความเข้าใจความแตกต่างของโครงสร้าง ข้อกําหนดในการประกอบ และลักษณะความน่าเชื่อถือช่วยให้วิศวกรสามารถเลือกแพ็คเกจที่เหมาะสมที่สุดสําหรับ สถาปัตยกรรมระบบ ข้อจํากัดทางกล และข้อกําหนดของวงจรชีวิต




